Scientific journal
Fundamental research
ISSN 1812-7339
"Перечень" ВАК
ИФ РИНЦ = 1,798
IMPROVEMENT OF ELECTROPHYSICAL CHARACTERISTICS OF ARSENIDE GALLIUM LAYERS OF THE RESISTORS OF INTEGRATED SCHEMES BY ION-RADIATION MODIFICATION
Важнейшим материалом микрокомпонентов монолитно-интегральных схем СВЧ является эпитаксиальный арсенид галлия (GaAs) с заданными электрофизическими характеристиками, одним из способов контролируемого создания которых является ионно-лучевое модифицирование (ИЛМ) [1, 2].
ИЛМ предъявляет многочисленные требования к параметрам эпитаксиального GaAs, непосредственно влияющим на электрофизические характеристики и морфологию полученных структур, на выполнение операций литографии и травления. К таким требованиям относятся: обработка поверхности пластин (не хуже 14 класса); поверхностная плотность точечных дефектов и дислокаций (менее 102 см-2); поверхностная плотность органических загрязнений (менее 10-9 г/см2).
Особое место в характеристике эпитаксиального GaAs занимают параметры, определяемые примесным составом кристалла: удельное сопротивление (ρ), разброс ρ по площади пластины, стабильность ρ при термической и радиационной обработке, коэффициенты диффузии основных и фоновых примесей, степень перекомпенсации материала. Значения этих параметров зависят от методов изготовления GaAs. Исходный низкоомный GaAs с мелкими, частично компенсированными примесями может быть переведен в полуизолирующее состояние различными способами (рис. 1). Во-первых, возможна непосредственная компенсация мелких доноров путем введения глубоких акцепторных центров с концентрацией NАА > NД – NА(NАА,NД,NА соответственно концентрации глубокого акцептора, мелкого донора).
При этом образуется материал с дырочной проводимостью. Во-вторых, возможна дальнейшая перекомпенсация глубокого акцептора глубоким донорным уровнем NДД в соотношении

Особенность этого случая заключается не только в формировании высокоомного материала с электронной проводимостью, но и в большей температурной стабильности ρ, так как уровень Ферми Ef локализуется в энергетическом интервале ЕАА < Ef < ЕДД.
На рис. 1 представлена также схема получения полуизолирующего GaAs с инверсным расположением глубоких, уровней (акцепторный уровень расположен выше энергии ионизации донора), соответствующим энергетическим параметрам примесей кислорода и хрома – глубоких примесей, наиболее часто применяемых при изготовлении полуизолирующего GaAs. С хромом связывают глубокий акцепторный уровень ЕАА + 0,69 эВ, либо ЕАА + 0,79 эВ, кислороду приписывается донорный уровень ЕДД – 0,75 эВ. Оптимальным является соотношение


Для рассмотренной схемы с определенными допусками можно считать, что концентрация электронов, поставляемых в зону проводимости с глубокого донорного уровня, равна



где Кп – степень перекомпенсации.
Так как ρ~(Δn)-1, для получения максимального удельного сопротивления необходимо увеличивать энергию ионизации доноров и уменьшать некомпенсированную долю примесей. При этом всегда выполняется соотношение n + p > 2ni и, вообще, ρ собственного полупроводника является теоретическим пределом ρ компенсированного полупроводника. Повышение ρ за счет снижения подвижности электронов (μ), как правило, нежелательно. Воспроизводимость параметров при раздельном легировании донорными и акцепторными примесями практически невозможна из-за неточной дозировки лигатуры, различной сегрегации и – перераспределения примесей, но может быть достигнута при легировании соединениями стехиометрического состава с компонентами, проявляющими донорную и акцепторную электрическую активность с большими энергиями ионизации.
Отличительная особенность ионного легирования - возможность легирования объекта любыми (без ограничений) элементами, в том числе не имеющих растворимость в материале данного объекта. Именно это обстоятельство и способствовало широкому применению принципов ионной модификации структуры с целью управления химическими, физическими и механическими свойствами.

Рис. 1. Схема перевода n GaAs в полуизолирующий n-GaAs: прямое (а), инверсное (б): - – нейтральная примесь, – • ионизированный акцептор, º – ионизированный донор
С целью изменения физико-механических свойств твердых тел используют облучение одного объекта несколькими типами ионов в различных их сочетаниях и последовательности в зависимости от целей ионной модификации. Так, для изменения физических свойств полупроводников используют последовательное облучение ионами инертного газа и соответствующих легирующих ионов [3, 4]. При этом выбор ионов инертного газа обусловлен необходимостью увеличить только количество радиационных дефектов при условии нейтральности самого иона к изменению физического свойства облучаемого полупроводника и отсутствия его химического взаимодействия, как с атомами полупроводника, так и с легирующими атомами. То есть основной недостаток в аналогичных способах облучения это то, что сами ионы инертного газа не используются для модификации свойств полупроводников. Также недостатками используемых способов ионного легирования являются: необходимость большого времени облучения для достижения заданных доз облучения при номинальных потоках ионов; высокие температуры (> 0,5Тплав) облучения или послерадиационного отжига, необходимые для формирования заданных по размеру и плотности дискретных выделений вторичной фазы; большая дисперсия выделений по размерам из-за флуктуационного механизма их одновременного зарождения и роста; невозможность обеспечить условия формирования строго заданного наномикронного размера и высокой объемной плотности выделений; трудности получения некогерентных (с резкой межфазной границей) выделений нанометрического размера в кристаллической решетке облучаемого объекта [5].
Наиболее удобными с практической точки зрения реализации предлагаемого способа являются атомы гелия (Не+). Источники ионов Не+ обладают высоким уровнем потока частиц, что позволяет эффективно за короткие времена достигать требуемых высоких (1–10 ат. %) концентраций атомов гелия в облучаемом объеме объекта. Более того, ионы Не+ обладают большим проективным пробегом, что обеспечивает его внедрение в облучаемый объект на большие глубины.
Известно [6], что гелиевые поры в твердых телах могут зарождаться и расти даже при комнатной температуре облучения. При этом они формируют ансамбль пор с высокой (> 1017 см-3 ) плотностью и размерами в интервале 1–2 нм. При определенных условиях облучения они формируют в облучаемой матрице материала упорядоченную сверхрешетку нанопор, что обеспечивает их максимально возможную объемную плотность при минимальных размерах. В работах В.Ф. Реутова и С.Н. Дмитриева [5, 7] экспериментально было показано, что атомы гелия стимулируют перераспределение легирующих элементов в решетке материала, инициируют образование выделений, способствуют синтезу фаз, например нитрида бора, а их скопления в виде гелиевых пор эффективно геттерируют легирующие элементы.
Недостатками существующих резисторов ИС СВЧ на GaAs являются низкая термическая стабильность изготавливаемых резистивных слоев и недостаточное пробивное напряжение локальных изолирующих областей.
Цель работы заключалась в экспериментальной оптимизации режимов облучения ионами гелия, определении ускоряющего напряжения и дозы для формирования локальных областей изоляции и получения электрически изолированных резисторов в составе ИС СВЧ.
Материалы и методы исследования
Образцы представляли собой эпитаксиальные структуры арсенида галлия с толщиной эпитаксиального слоя 0,3÷0,4 мкм и концентрацией электронов 2·1016см-3. Контактные площадки изготавливались методом вакуумного напыления алюминия толщиной 0,3 мкм с последующей фотолитографией по стандартной методике. Изолирующие области между контактными площадками создавались внедрением ионов гелия (Не+) на установке ионного легирования типа «Везувий» в диапазоне ускоряющего напряжения Uуск = 30–150 кВ и доз Ф = 1,2–1,4 мкКл/см2.
Результаты исследования и их обсуждение
Области резисторов выделялись формированием окон в фоторезистивной маске из ФП-383 толщиной 1 мкм и затем повторно внедрялись ионы гелия (Не+) с ускоряющим напряжением Uуск = 30–150 кВ и дозой Ф = 1,2–1,4 мкКл/см2 (рис. 2).
В результате получены резисторы с сопротивлением R = 320 Ом-380 Ом электрически изолированные от других резисторов в плоскости эпитаксиальной структуры слоем с удельным сопротивлением 106 Ом·см (рис. 3).
Экспериментально полученные зависимости сопротивления эпитаксиального арсенида галлия от ускоряющего напряжения ионов гелия приведены на рис. 4 и подтверждают модель Линхарда – Шарфа – Шиотта (ЛШШ) для внедрения легких ионов (для них электронное торможение является преобладающим процессом, если Uуск в пределах 300 кВ).
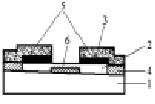 а
а 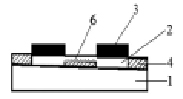 б
б
Рис. 2. Эпитаксиальная структура арсенида галлия после формирования окон в фоторезистивной маске (а) и повторного внедрения ионов гелия (б), образующих собственно резисторы: 1 – полуизолирующая подложка; 2 – эпитаксиальный слой арсенида галлия; 3 – контактные площадки; 4 – области изоляции после внедрения ионов гелия; 5 – фоторезистивная маска; 6 – резистор, образованный после повторного внедрения ионов гелия

Рис. 3. Зависимость электрического сопротивления эпитаксиального слоя арсенида галлия от дозы внедренных ионов гелия с ускоряющим напряжением: Δ – Uуск = 30 кВ; • – Uуск = 150 кВ

Рис. 4. Зависимость сопротивления от ускоряющего напряжения ионов гелия: o – область изоляции (Ф = 1,2 мкКл/см2); Δ – собственно сопротивление (Ф = 6 мкКл/см2)
Зная характер распределения вводимых облучением дефектов [1, 4], а также зависимость толщины нарушенного слоя от дозы ионов гелия (рис. 5), определены условия, при которых в ограниченной по горизонтали области эпитаксиальной структуры арсенида галлия образуется слой с высокой плотностью радиационных дефектов.
Экспериментально полученные режимы ИЛМ арсенида галлия ионами гелия для создания локальных изолирующих областей резисторов
|
Режимы внедрения ионов гелия |
Величина электрического сопротивления* |
|||
|
для создания изолирующих областей |
для получения резисторов |
|||
|
Ф, мкКл/см2 |
Uуск, кВ |
Ф, мкКл/см2 |
Uуск, кВ |
R, Ом |
|
1,2 |
30 |
2 |
30 |
5,5·105 |
|
1,2 |
30 |
4 |
30 |
9·103 |
|
1,2 |
30 |
6 |
30 |
360 |
|
1,2 |
30 |
8 |
30 |
320 |
|
1,2 |
30 |
3 |
150 |
8·105 |
|
1,2 |
30 |
6 |
150 |
1·104 |
|
1,2 |
30 |
9 |
150 |
400 |
|
1,2 |
30 |
12 |
150 |
380 |
|
1,2 |
30 |
15 |
150 |
50 |
Примечание. *среднее значение номинала сопротивления; усреднение проведено для каждого режима по группе из 50 резисторов; разброс номинала по каждой группе не превышает ± 3 %.

Рис. 5. Зависимость толщины нарушенного слоя от дозы ионов гелия: Δ – Uуск = 150 кВ; • – Uуск = 30 кВ
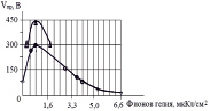 а
а  б
б
Рис. 6. а – зависимость пробивного напряжения (Vпр) изолирующего слоя от дозы (Ф) ионов гелия: o – Uуск = 30 кВ, ток утечки Iут = 10 мкА, без дополнительной термообработки; Δ– Uуск = 30 кВ, ток утечки Iут = 10 мкА, термообработка +300 °С; б – зависимость пробивного напряжения (Vпр) резисторов от температуры отжига (время отжига 60 мин): Δ – Uуск = 30 кВ, Ф = 8 мкКл/см2; • – Uуск = 30 кВ, Ф = 12 мкКл/см2; o – Uуск = 150 кВ, Ф = 8 мкКл/см2; □ – Uуск = 150 кВ, Ф = 12 мкКл/см2
Методом измерения вольт-фарадных характеристик и емкостной переходной спектроскопии имплантированных ионами гелия слоев GaAs найдены четыре ловушки электронов с энергией активации 0,79; 0,65; 0,32; 0,27 эВ, причем два наиболее глубоких центра доминируют при высоких дозах облучения 8–12 мкКл /см2.
Результаты экспериментов по влиянию дозы ионов и температурной обработки на параметры изолирующих областей резисторов представлены на рис. 6.
 а
а  б
б
Рис. 7. а – зависимость пробивного напряжения (Vпр) изолирующего слоя от дозы: Δ – ионов гелия (Не+); Uуск = 30 кВ; ток утечки Iут = 10 мкА; □ – ионов гелия (Не+); Uуск = 150 кВ; ток утечки Iут = 10 мкА; б – зависимость пробивного напряжения (Vпр) резисторов, изготовленных: Δ – облучением ионами гелия; Uуск = 30 кВ; Ф = 12 мкКл/см2 от температуры отжига (время отжига 60 мин); □ – облучением ионами гелия; Uуск = 150 кВ; Ф = 12 мкКл/см2 от температуры отжига (время отжига 60 мин)
Заметное возрастание пробивного напряжения областей арсенида галлия, подвергнутого имплантации ионов гелия, наблюдается при дозе ионов выше 0,4 мкКл/см2. В интервале 0,2–0,8 мкКл/см2 происходит монотонное увеличение Vпр от исходного значения до 300 В (в зависимости от исходных параметров эпитаксиального слоя). В области Ф ≥ 1,2–1,4 мкКл/см2 наклон дозовой зависимости уменьшается, зависимость стремится к насыщению с абсолютным значением сопротивления изолирующих областей 5×105–106 Ом (рис. 3, б).
Как следует из данных рис. 6, б, параметры полученных имплантацией ионов гелия изолирующих слоев термостабильны до температуры ~500 °С и практически не изменяются после часового отжига. При температуре 300 °С термообработка значительно увеличивает пробивное напряжение изолирующих областей арсенида галлия. Уместно предположить, что низкотемпературный отжиг приводит к распаду нестабильных радиационных нарушений, отжигу и миграции быстро диффундирующих дефектов на стоки.
Зависимость сопротивления и пробивного напряжения от дозы ионов гелия (рис. 7) позволяет предположить отжиг некоторых центров в запрещенной зоне арсенида галлия либо их комплексообразование.
Таким образом, исследовано влияние облучения ионами гелия с ускоряющим напряжением 30–150 кВ и дозой 1,2–1,4 мкКл/см2 для формирования областей локальной изоляции и повторного внедрения ионов гелия с ускоряющим напряжением 30–150 кВ и дозой 6–12 мкКл/см2 для получения электрически изолированных резисторов.
Заключение
Установленные режимы ионно-лучевого модифицирования положены в основу технологии изготовления электрически изолированных резисторов микросхем на арсениде галлия с высокой термостабильностью (до 500 °С) и высоким пробивным напряжением (до 450 В) изолирующих слоев арсенида галлия, что расширяет возможности при проектировании микросхем.
Исследования выполнены при финансовой поддержке Минобрнауки РФ в рамках государственного задания образовательным организациям высшего образования, подведомственным Минобрнауки РФ (проект № 11.1943.2017/ПЧ).
Библиографическая ссылка
Родионов И.В., Перинский В.В., Перинская И.В., Куц Л.Е. ПОВЫШЕНИЕ ЭЛЕКТРОФИЗИЧЕСКИХ ХАРАКТЕРИСТИК СЛОЕВ АРСЕНИДА ГАЛЛИЯ РЕЗИСТОРОВ ИНТЕГРАЛЬНЫХ СХЕМ ИОННО-ЛУЧЕВЫМ МОДИФИЦИРОВАНИЕМ // Фундаментальные исследования. 2017. № 10-2. С. 267-272;URL: https://fundamental-research.ru/en/article/view?id=41823 (дата обращения: 07.05.2026).



