Scientific journal
Fundamental research
ISSN 1812-7339
"Перечень" ВАК
ИФ РИНЦ = 1,798
SUBMICRON STRUCTURING OF SILICON SUBSTRATE USING FOCUSED ION BEAMS
Технология формирования устройств наноэлектроники и наносистемной техники неразрывно связана с формированием на поверхности твердого тела субмикронного профиля различной конфигурации. Конструкции перспективных приборов зачастую предусматривают создание сложных наноразмерных 3D-структур и их прецизионную локализацию на подложке. Применение традиционных методов оптической литографии ограничено дифракционным пределом разрешения и необходимостью использования операций жидкостного или плазменного травления, что сужает возможности технологии и не всегда позволяет решать задачи создания современных устройств с нанометровыми размерами [5].
В настоящее время одним из наиболее перспективных и динамично развивающихся методов субмикронного структурирования поверхности твердого тела является метод фокусированных ионных пучков (ФИП) [6–8].
Несмотря на многочисленные достоинства метода ФИП [8], ионно-лучевое субмикронное профилирование сопряжено с трудностями, связанными с отсутствием средств эффективной генерации растровых графических файлов, используемых в качестве шаблонов, которые определяют размеры, форму и расположение формируемых на положке структур, а также сложностью выбора режимов воздействия, обеспечивающих наибольшую точность формирования профиля [9].
Целью данной работы является исследование процессов безмасочного субмикронного структурирования поверхности подложки кремния методом фокусированных ионных пучков с использованием растровых графических шаблонов.
В НОЦ «Нанотехнологии» Южного федерального университета для эффективного формирования структур методом ФИП был разработан пакет прикладных программ Unigen, позволяющий генерировать растровые графические шаблоны в форматах *.bmp и ASCII для безмасочного структурирования подложки фокусированным ионным пучком с учетом особенностей взаимодействия ионов с поверхностью твердого тела, размерных эффектов, закономерностей переосаждения распыленного материала, и дающий возможность мультиплицирования рисунка по заданной области подложки.
Экспериментальные исследования в данной работе производились с использованием растрового электронного микроскопа с колонной ФИП Nova NanoLab 600, сконфигурированного для решения технологических задач (FEI Company, Нидерланды), а также модуля ФИП многофункционального сверхвысоковакуумного нанотехнологического комплекса НАНОФАБ НТК-9 (ЗАО «Нанотехнология-МДТ», Россия) [1–4].
В ходе экспериментальных исследований процессов безмасочного структурирования поверхности подложки генерировался набор растровых шаблонов с различными параметрами, представляющих собой массив из 9 структур пирамидальной формы с разрешением от 512×512 до 1024×1024 точек (рис. 1).
a  б
б 
Рис. 1. Растровый графический шаблон для ионно-лучевого травления ФИП (а) – 2D, (б) – 3D
Для исследования влияния соотношения параметров ФИП и характеристик шаблона на точность воспроизведения топологии при травлении варьировались разрешение шаблона, количество проходов пучка по шаблону, размер шаблона, шаг перемещения пучка, время воздействия ионного пучка в точке и ток ионного пучка. Травление кремниевой подложки КДБ-10 с использованием сгенерированных шаблонов производилось на модуле ФИП комплекса НАНОФАБ НТК-9.
Параметры ионно-лучевого травления для каждого из выбранных режимов приведены в таблице.
Параметры ионно-лучевого травления структур сложного профиля
|
Режим |
Разрешение шаблона |
Кол-во проходов |
Время |
Размер |
Шаг, |
Время |
Ток |
Макс. |
|
1 |
512×512 |
100 |
1001 |
10×10 |
20 |
10 |
5 |
22 |
|
2 |
512×512 |
100 |
561 |
5×5 |
10 |
30 |
5 |
5 |
|
3 |
512×512 |
200 |
1123 |
5×5 |
5 |
20 |
10 |
7 |
|
4 |
512×512 |
100 |
561 |
5×5 |
4 |
30 |
5 |
18 |
|
5 |
1024×1024 |
500 |
1554 |
2×2 |
30 |
1 |
30 |
40 |
|
6 |
512×512 |
200 |
561 |
2×2 |
10 |
20 |
10 |
9,5 |
После ионно-лучевого травления образец по сверхвысоковакуумной магистрали передавался в модуль сканирующей зондовой микроскопии, где производились исследования сформированных структур методом полуконтактной атомно-силовой микроскопии (АСМ) (рис. 2). После этого профилограммы сформированных структур, полученные на основе АСМ-изображений, сравнивались с профилями модельной структуры, полученными в ПО для генерации шаблонов для безмасочного структурирования поверхности подложек методом ФИП. Основным критерием, по которому производилось сравнение и выбор режимов, было выбрано максимальное значение разности между профилями экспериментальной и модельной структур, которая измерялась в каждой точке профиля с шагом 10 нм. Значения наилучшей максимальной разности внесены
в таблицу.
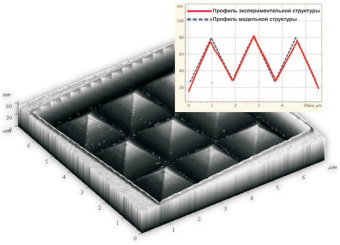
Рис. 2. АСМ-изображение топологии сформированной ионно-лучевым травлением ФИП по растровому шаблону и профилограмма экспериментальной структуры в сравнении с модельным профилем
В результате проведенной работы исследованы режимы субмикронного структурирования кремниевой подложки методом фокусированных ионных пучков с использованием растровых графических шаблонов, сгенерированных при помощи пакета прикладных программ Unigen. Выявлены режимы, обеспечивающие наилучшее соответствие между профилями модельной и экспериментальной структур. Полученные результаты будут использованы при корректировке моделей и алгоритмов, применяемых для генерации шаблонов, что позволит повысить точность воспроизведения смоделированного профиля на подложке. Результаты, полученные в настоящей работе, также могут быть использованы при разработке технологических процессов формирования перспективной элементной базы наноэлектроники и наносистемной техники.
Работа выполнена при поддержке государственными соглашениями № 12-08-90045/12, № 14.А18.21.0126, № 14.A18.21.0923, № 14.A18.21.0933, № 14.A18.21.0900, № 14.A18.21.0887, № 14.A18.21.1206 в рамках проектов РФФИ и ФЦП «Научные и научно-педагогические кадры инновационной России» на 2009–2013 годы.
Рецензенты:
Рындин Е.А., д.т.н., профессор, ведущий научный сотрудник ЮНЦ РАН;
Жорник А.И. д.ф.-м.н., профессор кафедры теоретической, общей физики и технологии ФГБОУ ВПО ТГПИ.
Работа поступила в редакцию 26.10.2012.
Библиографическая ссылка
Коломийцев А.С., Громов А.Л., Ильин О.И., Лисицын С.А., Катханов Б.С. СУБМИКРОННОЕ СТРУКТУРИРОВАНИЕ ПОВЕРХНОСТИ ПОДЛОЖЕК КРЕМНИЯ МЕТОДОМ ФОКУСИРОВАННЫХ ИОННЫХ ПУЧКОВ // Фундаментальные исследования. 2012. № 11-3. С. 615-618;URL: https://fundamental-research.ru/en/article/view?id=30583 (дата обращения: 13.05.2026).



