Создание элементной базы интегральных схем на основе гетеропереходных квантовых областей является одним из основных направлений развития наноэлектроники. В рамках данного направления разработан ряд полупроводниковых приборов, характеризующихся быстродействием, не ограниченным временем пролета электронами активных областей (каналов) наноструктур. В основу функционирования приборов данного класса положен принцип управляемой электрическим полем передислокации максимума амплитуды волновых функций электронов в системе туннельно-связанных квантовых ям, разделенных туннельными гетеробарьерами [2, 3, 4, 7, 8].
Одной из особенностей метода построения наноструктур с управляемой передислокацией максимума амплитуды волновых функций носителей заряда является необходимость формирования раздельных омических контактов к квантовым областям шириной 15 – 40 нм, разделенных туннельным гетеробарьером шириной 2–5 нм, что представляет собой определенную конструктивно-технологическую проблему.
Учитывая данную особенность, а также тот факт, что основные характеристики наноструктур в значительной степени определяются качеством омических контактов, обеспечивающих связь и взаимодействие интегральных элементов на кристалле, для более эффективной оптимизации режимов технологического процесса формирования омических контактов целесообразно проводить предварительное моделирование процесса диффузии легирующих примесей.
Численная модель технологического процесса
Традиционно омические контакты к интегральным элементам на основе GaAs формируют посредством диффузии доноров (как правило, Ge) и акцепторов (чаще всего Zn) из нанесенных на поверхность структуры пленок AuGe и AuZn соответственно, при температуре 450–600 °С в течение 10–60 с.
Математическое моделирование процесса диффузии легирующих примесей выполняется с использованием уравнения диффузии [1]:
 (1)
(1)
где N – концентрация легирующей примеси; D – коэффициент диффузии примеси; f – плотность источников (стоков) легирующей примеси; t – время; ∇ – оператор набла.
Поскольку в рассматриваемой задаче источники легирующих примесей локализованы на поверхности структуры, правая часть уравнения (1) может быть принята равной нулю:
 (2)
(2)
На участках границы, соответствующих нанесенным на поверхность структуры источникам легирующих примесей, при допущении, что в рассматриваемом временном интервале 10–60 с поверхностный источник примеси может считаться неограниченным, задаются граничные условия первого рода:
 (3)
(3)
где NMAX – предел растворимости легирующей примеси при заданной температуре.
На остальных участках границы задаются граничные условия второго рода:
 (4)
(4)
где n – нормаль к границе.
Начальное условие определяется распределением легирующих примесей по координатам в начальный момент времени tMIN:
 (5)
(5)
где N0 – распределение легирующей примеси по координатам в начальный момент времени.
Численное решение системы уравнений (2)–(5) проводилось с использованием метода конечных разностей на координатной и временной сетках:

 (6)
(6)
где Gxy – множество точек координатной сетки; Gt – множество точек временной сетки;
i, j, k – индексы точек координатной и временной сеток; (xi, yj) – точки координатной сетки; tk – точки временной сетки; I – число точек сетки по координате x; J – число точек сетки по координате y; K – число точек сетки по времени t.
В результате дискретизации системы (2)–(5) на сетках (6) получили следующую систему линейных алгебраических уравнений:
 (7)
(7)
 (8)
(8)
 (9)
(9)
 (10)
(10)
где Q – область решения задачи, включая внутренние и граничные точки; W1 – области границы, соответствующие нанесенным на поверхность структуры источникам легирующих примесей; W2 – области границы, на которых источники легирующих примесей отсутствуют.
Результаты моделирования
Решение системы уравнений (7)–(10) выполнялось для фрагмента исследуемой наногетероструктуры, схематически
показанного на рис. 1 и представляющего собой окрестность двух омических контактов к туннельно-связанным квантовым ямам.
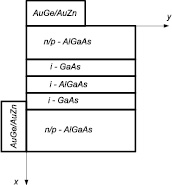
Рис. 1. Область моделирования
Рассматриваемая задача предполагает определение нестационарного распределения по координатам атомов Ge или Zn в полупроводниковой структуре на основе гетеропереходов GaAs/AlGaAs в процессе термодиффузии омических контактов из поверхностного источника AuGe или AuZn, соответственно, в диапазоне температур
450–600 оС. В процессе численного моделирования учтен предел растворимости исследуемых примесей в GaAs в рассматриваемом диапазоне температур, а также исследован процесс разгонки исходных примесей Si и Be в GaAs/AlGaAs-гетероструктуре за время формирования омических контактов.
Система уравнений (7)–(10) решалась итерационно методом Гаусса‒Зейделя на неравномерной координатной сетке, содержащей 36 точек по координате x и 41 точку по координате y. Временная сетка содержала 7 отсчетов. Общее число уравнений составило 10332. Разработанный пакет прикладных программ численного моделирования процесса формирования омических контактов использует методы вычислений с разреженными матрицами коэффициентов, что позволяет при необходимости увеличить размерность задачи, определяемую числом точек координатной и временной сеток, в десятки раз.
Температурная зависимость коэффициента диффузии легирующей примеси определялась на основе экспериментальных данных, приведенных в работах [5, 6].
На рис. 2, 3 приведены распределения суммарной концентрации атомов доноров (Ge, Si) и акцепторов (Zn, Be) по координатам в моменты времени 10 и 60 с при температуре диффузии 600 °С, полученные в результате численного решения системы уравнений (7) – (10) на координатной и временной сетках (6).
а б
б
Рис. 2. Распределения концентрации доноров по координатам в моменты времени 10 с (а) и 60 с (б) при температуре 600 °С
Анализ полученных в работе результатов численного моделирования показал, что при температуре процесса вжигания до 600 °С и времени вжигания до 60 с возможно формирование раздельных омических контактов к туннельно-связанным квантовым областям с электронной проводимостью при минимальном расстоянии между нанесенными на поверхность наноструктуры областями AuGe до 20 нм. Для формирования контактов к туннельно-связанным квантовым областям с дырочной проводимостью расстояние между областями AuZn должно быть увеличено до 30 нм. При этом разгонка исходных легирующих примесей Si и Be в слоях наногетероструктуры наблюдается в пределах 2–3 нм.
При снижении температуры процесса вжигания до 470–500 °С минимальное расстояние между областями AuGe/AuZn может быть уменьшено
до 10–15 нм.
Приведенные выше выводы справедливы лишь для наноструктур с достаточно малой плотностью дефектов в приповерхностных областях. Увеличение плотности дефектов приводит к значительному (на 1–2 порядка) росту коэффициентов диффузии и, таким образом, требует предварительной экспериментальной оценки данных коэффициентов для конкретной партии образцов.
а б
б
Рис. 3. Распределения концентрации акцепторов по координатам в моменты времени 10 с (а) и 60 с (б) при температуре 600 °С
Заключение
Разработанная модель и пакет прикладных программ численного моделирования технологического процесса термодиффузии омических контактов к квантовым областям наногетероструктур позволяют получить нестационарные распределения по координатам концентраций различных легирующих примесей в широком диапазоне температур и времени с целью предварительной оптимизации параметров исследуемого технологического процесса, а также в качестве исходных данных для последующего численного анализа вольт-амперных характеристик наноструктур с учетом сопротивлений областей омических контактов.
Работа выполнена при финансовой поддержке Министерства образования и науки Российской Федерации (Гос. контракт № 16.740.11.0425 от 03.12.2010, гос. соглашение № 14.А18.21.0126) в рамках ФЦП «Научные и научно-педагогические кадры инновационной России» на 2009–2013 годы.
Рецензенты:
Агеев О.А., д.т.н., профессор, директор НОЦ «Нанотехнологии»;
Жорник А.И., д.ф.-м.н., профессор кафедры теоретической, общей физики и технологии ФГБОУ ВПО ТГПИ.
Работа поступила в редакцию 26.10.2012.



